高电阻率硅因其低损耗和高性能特点,在电信系统中的射频(RF)器件应用中备受关注。尤其是作为绝缘硅(SOI)技术的理想基板,高电阻率硅的需求日益增加。然而,确定高电阻率硅的导电类型(n型或p型)一直是一个挑战。传统方法如表面光电压(SPV)法受限于表面条件和低载流子浓度。本文提出了一种结合氢氟酸(HF)处理与扩展电阻分布分析(SRP)的新方法,通过借助Xfilm埃利扩展电阻SRP测试仪调控电阻率变化和表面能带弯曲,实现了高电阻率硅导电类型的快速、准确判定。
实验设计与方法
/Xfilm
样品制备与处理
- 样品选择:采用300 mm(100)晶向的直拉(CZ)硅片,电阻率>1000 Ω·cm,分别通过掺杂硼(p型)和磷(n型)控制导电类型。
- 热处理:在氮气环境中750℃退火30秒,消除初始热施主。
- HF处理:使用49%氢氟酸蚀刻3分钟,随后去离子水清洗,获得氢钝化表面。
- SRP测量:通过斜面研磨制备样品,测量表面至体区的电阻率分布。
表征与计算
- XPS与UPS:分析HF处理后表面元素组成及能带结构变化。
- 第一性原理计算:基于CASTEP软件,模拟Si-F和Si-OH键对表面静电势和电子密度的影响。

SRP揭示的电阻率变化规律
/Xfilm
(a)SRP测量示意图;(b)呈现经HF处理和未处理的n型、p型高电阻率抛光硅片的SRP电阻率
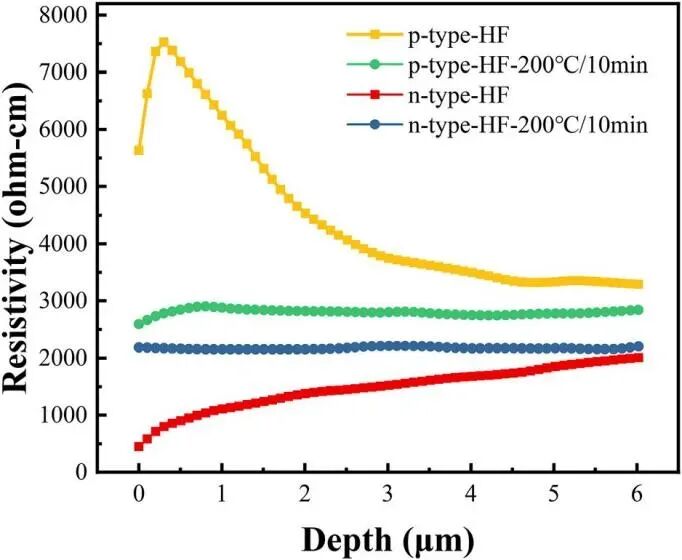
HF 处理后的 n 型和 p 型硅片在 200°C 退火 10min 前后的电阻率分布HF处理前:n型和p型硅的电阻率分布均呈平坦趋势。HF处理后:
- n型硅:近表面电阻率显著降低。
- p型硅:近表面电阻率升高,且出现电阻率峰值,表明表面导电类型可能反转。
热处理恢复:200℃退火10分钟后,电阻率恢复至体区水平,表明HF处理的影响可逆。
表面化学与能带结构表征
/Xfilm

(a)对比原生氧化物和 HF 蚀刻表面的 XPS 光谱;(b)给出 n 型和 p 型 HF 处理硅的 Si 2p 核心光谱;(c)(d)分别为 n 型和 p 型 HF 处理硅片的 UPS 测量结果
XPS分析:HF处理后,硅表面残留F元素,Si 2p峰向高结合能方向偏移,表明表面费米能级向导带底移动。UPS分析:n型硅的功函数低于p型,且价带顶与费米能级的能量差显著增大,进一步证实表面能带弯曲。
计算模拟结果
/Xfilm

Si–F与Si–OH键对硅电学性质的影响(a) 理想硅表面、含Si–F键表面及含Si–OH键表面的几何结构(b) 三组模型的电子密度差分布;(c) 静电势分布
第一性原理计算表明,Si-F和Si-OH键会导致硅表面能带向下弯曲。由于氟和羟基的电负性高于硅,与硅原子键合的氟和羟基周围的电子密度偏向氟和羟基,导致硅原子带正电。模拟结果与实验观察一致,表明HF处理后n型硅片表面形成载流子积累,而p型硅片表面出现耗尽甚至反型。
方法验证与应用
/Xfilm
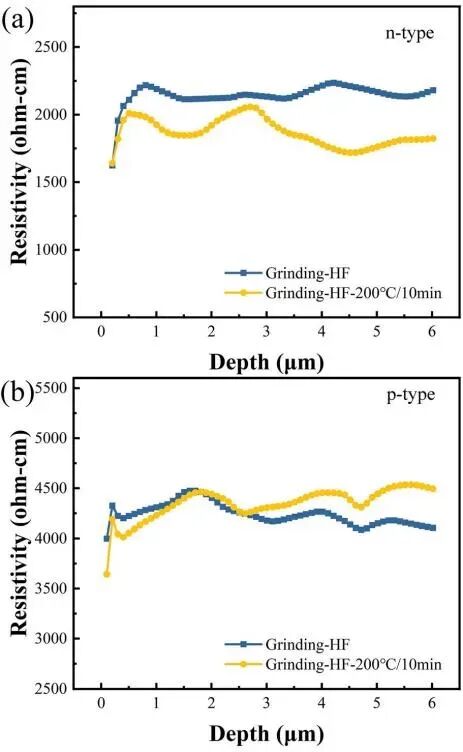
磨斜面后氢氟酸(Grinding-HF)处理后n型和p型硅片在200°C退火前后的电阻率分布
为验证SRP 结合 HF 处理确定导电类型方法的准确性,对 p 型硅片进行热施主生成退火(DGA,450°C,4h)处理,将其导电类型转变为 n 型。对比处理前后 HF 处理硅的近表面电阻率分布发现,转变为 n 型后的硅片近表面电阻率降低,与 n 型硅片的特征一致。这充分证明,在磨斜面之前进行 HF 处理,根据处理后的表面电阻率与体电阻率的大小关系,能够可靠地判断硅片的导电类型:若表面电阻率高于体电阻率,则硅片为 p 型;反之,则为 n 型。本研究通过实验和理论计算,详细探讨了HF处理对高电阻率硅表面电学性质的影响。研究结果表明,HF处理可以显著改变n型和p型硅的近表面电阻率,且这种变化可以通过SRP测量进行定量分析。
Xfilm埃利扩展电阻SRP测试仪
/Xfilm

借助此自动化系统,可全面分析器件加工中所有硅基半导体结构的载流子浓度与电阻率分布。测量范围覆盖尖端应用需求。
- 超宽测量范围:扩展电阻1Ω - 109Ω,灵活适配多种应用
- 高分辨率:纵向分辨率≤5 nm、横向分辨率<1 μm,无重叠测量
- 原位斜面角度测量(In-Situ BAM)范围:0.1° - 5°
本研究通过Xfilm埃利扩展电阻SRP测试仪对SRP测量结合实验与理论计算,揭示了HF处理对硅表面电学特性的调控机制,并开发了一种高效、无损的导电类型判定方法。未来可进一步探索其他表面处理剂对能带工程的潜在影响,为半导体材料设计提供新思路。
原文出处:《Determination of conduction type in high-resistivity silicon by combining spreading resistance profiling (SRP) with hydrofluoric acid treatment》
*特别声明:本公众号所发布的原创及转载文章,仅用于学术分享和传递行业相关信息。未经授权,不得抄袭、篡改、引用、转载等侵犯本公众号相关权益的行为。内容仅供参考,如涉及版权问题,敬请联系,我们将在第一时间核实并处理。











